wlcsp封裝技術分析
WLCSP即晶圓級芯片封裝方式,英文全稱是Wafer-Level Chip Scale Packaging Technology,不同于傳統的芯片封裝方式(先切割再封測,而封裝后至少增加原芯片20%的體積),此種最新技術是先在整片晶圓上進行封裝和測試,然后才切割成一個個的IC顆粒,因此封裝后的體積即等同IC裸晶的原尺寸。它號稱是封裝技術的未來主流,已投入研發的廠商包括FCT、Aptos、卡西歐、EPIC、富士通、三菱電子等。
本文引用地址:http://www.czjhyjcfj.com/article/185571.htm它在結束前端晶圓制作流程的晶圓上直接完成所有的操作。在封裝過程中再將芯片從晶圓上分離,從而使WLCSP可以實現與芯片尺寸相同的最小的封裝體積,這幾乎是最終的封裝縮微技術。
晶圓級芯片規模封裝技術,融合薄膜無源器件技術及大面積規格制造技術能力,不僅提供節省成本的解決辦法,而且提供與現存表面貼裝組裝過程相符合的形狀因素。芯片規模封裝技術既提供性能改進路線圖,又降低了集成無源器件的尺寸。
自1998年可行性的WLCSP技術宣布以來,近年市場上已經出現了各種不同類型的WLCSP。這種技術已經使用在移動電子設備中,比如用于移動電話的電源供給芯片,并且延伸到邏輯產品的應用中。
WLCSP是倒裝芯片互連技術的一個變種。借助WLCSP技術,裸片的有源面被倒置,并使用焊球連接到PCB。這些焊球的尺寸通常足夠大(在0.5mm間距、預回流焊時有300μm),可省去倒裝芯片互連所需的底部填充工藝。如圖1所示,
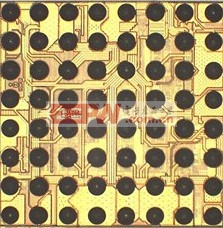
圖1:WLCSP封裝。
封裝結構
WLCSP可以被分成兩種結構類型:直接凸塊和重分布層(RDL)
直接凸塊
直接凸塊WLCSP包含一個可選的有機層(聚酰亞胺),這個層用作有源裸片表面上的應力緩沖器。聚酰亞胺覆蓋了除連接焊盤四周開窗區域之外的整個裸片面積。在這個開窗區域之上濺射或電鍍凸塊下金屬層(UBM)。UBM是不同金屬層的堆疊,包括擴散層、勢壘層、潤濕層和抗氧化層。焊球落在UBM之上(因此叫落球),然后通過回流焊形成焊料凸塊。直接凸塊WLCSP的結構如圖2所示。
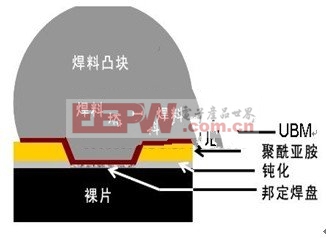
圖2:直接凸塊WLCSP。
重分布層(RDL)
圖3是一種重分布層(RDL)WLCSP。這種技術可以將為邦定線(邦定焊盤安排在四周)而設計的裸片轉換成WLCSP。與直接凸塊不同的是,這種WLCSP使用兩層聚酰亞胺層。第一層聚酰亞胺層沉積在裸片上,并保持邦定焊盤處于開窗狀態。RDL層通過濺射或電鍍將外圍陣列轉換為區域陣列。隨后的結構類似直接凸塊——包括第二個聚酰亞胺層、UBM和落球。
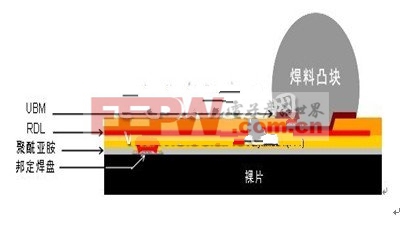
圖3:重分布層(RDL)WLCSP
WLCSP的優點:
WLCSP的封裝方式,不僅明顯地縮小內存模塊尺寸,而符合行動裝置對于機體空間的高密度需求;另一方面在效能的表現上,更提升了數據傳輸的速度與穩定性。無需底部填充工藝,可以使用標準的SMT組裝設備。
1原芯片尺寸最小封裝方式:
WLCSP晶圓級芯片封裝方式的最大特點便是有效地縮減封裝體積,封裝外形更加輕薄。故可搭配于行動裝置上而符合可攜式產品輕薄短小的特性需求。








評論