TSV產值2013年可達140億~170億美元 滲透率達5%
國際半導體展(Semicon Taiwan 2009)的3D IC論壇近日熱鬧展開,日月光集團研發處總經理唐和明再次強調未來3年后3D IC技術將會進入成熟階段,3D系統級封裝(SiP)和3D系統單芯片(SoC)可望相輔相成。很多封裝方式可以藉著矽穿孔(Through Silicon Via;TSV)降低成本、增加傳輸速度,研究機構Gartner預估TSV全球產值到2013年可望達到140億~170億美元,屆時將有5~6%的全球裝置采用。
本文引用地址:http://www.czjhyjcfj.com/article/98717.htm在1日的3D IC前瞻科技論壇中,現場座無虛席,顯示不少業界人士對于先進的封裝技術相當有興趣。擔任開場演講的日月光集團研發處總經理唐和明表示,過去幾年來,3D IC的技術發展迅速,現今3D IC的時代已經來臨,包括鏡頭模塊用影像傳感器已導入3D IC,并開始量產,預期未來到2012~2015年此技術將會擴及到CPU、基頻IC、手機芯片IC等領域,在此3年內3D IC的技術將會進入成熟階段。
唐和明表示,隨著消費性電子產品走向輕薄且功能復雜化,但晶粒的設計卻不能無限放大。以臺北信義區土地為例,在有限的土地面積上,可以興建101的世界高樓,3D IC的設計就是立體堆疊的概念。把晶粒磨得很薄之后,在上面放上1、2顆的IC,可達到體積縮小、功能放大的效果。隨著摩爾定律放緩,SoC技術會繼續走下去,而SiP應用也會愈來愈多,2者會相輔相成。
隨后接棒發表演說的Gartner半導體研究的首度分析師Mark Stromberg表示,有很多封裝設計可以藉TSV以達到最佳電訊傳輸效率。結合TSV技術在晶圓厚度方向的優點,3D IC SiP封裝技術不僅產品上市時間快于SoC,也可提供與SoC互相搭配的封裝解決方案。
Stromberg并預估TSV到2013年的全球產值約140億~170億美元,占全球裝置市場的比重約5~6%,其中到2013年存儲器應用TSV的產值約40億~50億美元。目前采用TSV最大宗的裝置應用為微機電(MEMS)和影像傳感器,預期到2010年采用范圍可以擴大至DSP、NAND Flash、DRAM、RF和通訊IC等,2011年將可延伸到繪圖芯片、電源供應器和功率放大器等。
Stromberg認為,TSV目前仍面臨多方挑戰,包括測試、3D CAD Tools、材料、設備等,但這也是另一波的商機。他預估TSV設備2013年產值約為12億美元。




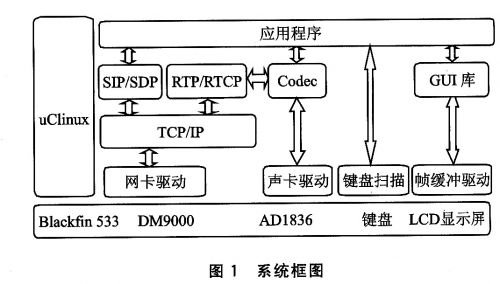



評論