博通推出行業首個 3.5D F2F 封裝平臺,富士通 MONAKA 處理器采用
12 月 6 日消息,博通當地時間昨日宣布推出行業首個 3.5D F2F 封裝技術 3.5D XDSiP 平臺。3.5D XDSiP 可在單一封裝中集成超過 6000mm2 的硅芯片和多達 12 個 HBM 內存堆棧,可滿足大型 AI 芯片對高性能低功耗的需求。
本文引用地址:http://www.czjhyjcfj.com/article/202412/465248.htm具體來看,博通的 3.5D XDSiP 在 2.5D 封裝之外還實現了上下兩層芯片頂部金屬層的直接連接(即 3D 混合銅鍵合),同時具有最小的電氣干擾和卓越的機械強度。
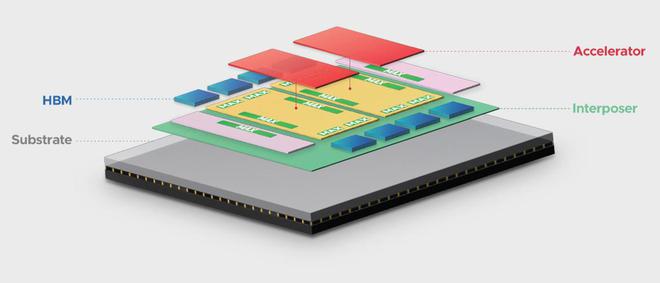
這一“面對面”的連接方式相比傳統“面對背”式芯片垂直堆疊擁有 7 倍的信號密度,最大限度減少了 3D 芯片堆棧中各組件間的延遲,相較平面芯片間 PHY 接口功耗大幅降低九成,實現了更小的中介層和封裝尺寸,從而在節省成本的同時還改善了大面積封裝的翹曲問題。
博通公司高級副總裁兼 ASIC 產品部總經理 Frank Ostojic 表示:
先進的封裝對于下一代 XPU 集群至關重要,因為我們已經達到了摩爾定律的極限。 通過與客戶密切合作,我們在臺積電和 EDA 合作伙伴的技術和工具基礎上創建了 3.5D XDSiP 平臺。 通過垂直堆疊芯片元件,博通的 3.5D 平臺使芯片設計人員能夠為每個元件搭配合適的制造工藝,同時縮小中介層和封裝尺寸,從而顯著提高性能、效率和成本。
臺積電業務開發、全球業務資深副總經理兼副共同營運長張曉強表示:
在過去幾年中,臺積電與博通緊密合作,將臺積電最先進的邏輯制程和 3D 芯片堆疊技術與博通的設計專長相結合。 我們期待著將這一平臺產品化,以實現 AI 創新和未來增長。
博通表示,其大多數“消費級 AI 客戶”已采用3.5D XDSiP 平臺技術,正在開發的 3.5D 產品已達 6 款,將于 2026 年 2 月開始生產出貨。其中富士通已明確將在其 2nm 制程 Arm 服務器處理器 FUJITSU-MONAKA 使用這一平臺。




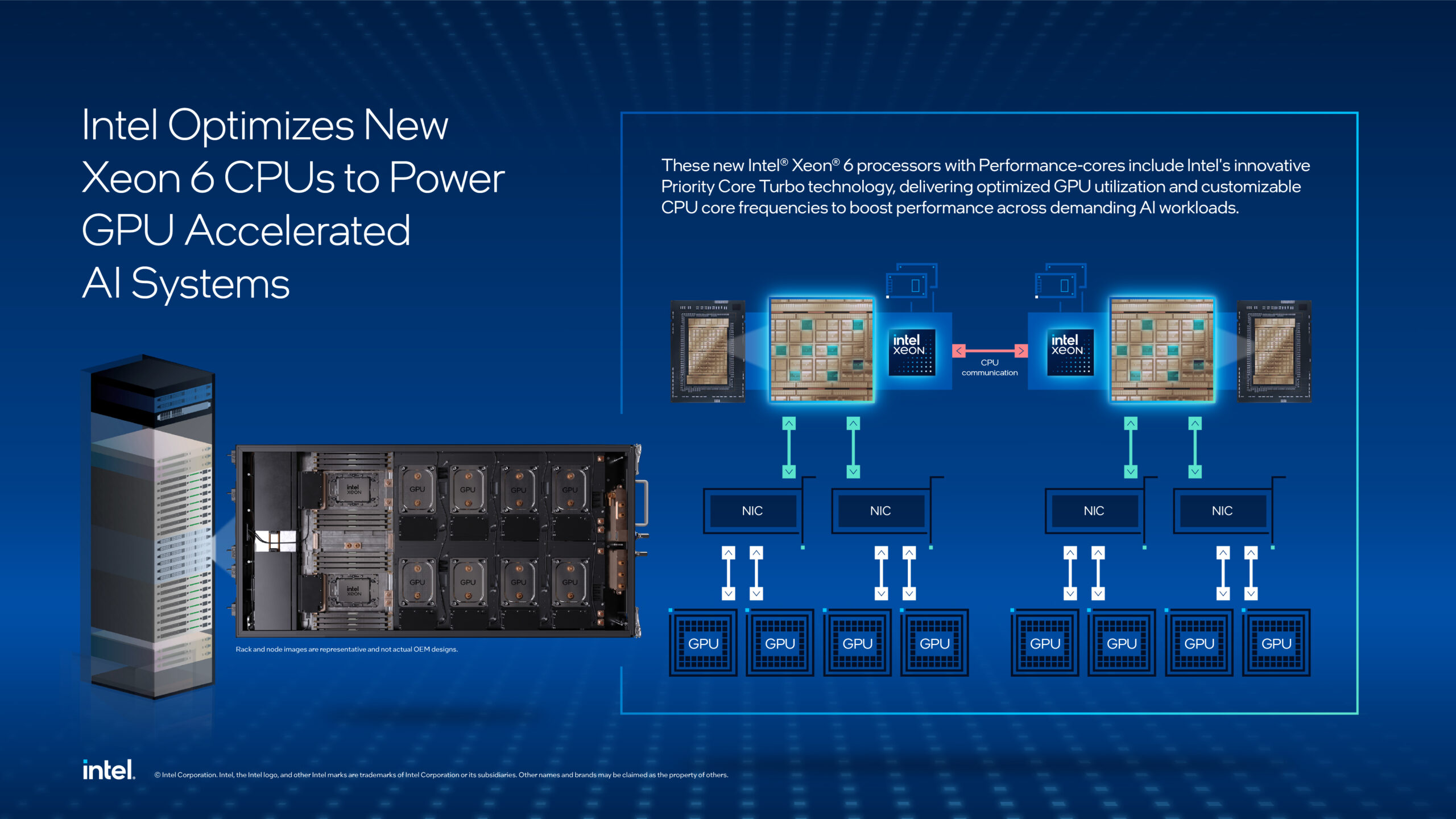












評論