先進封裝再進化! 解析NVIDIA GR150導入「CoWoP」的真正意義
AI與高效運算(HPC)進入爆發增長時代,芯片制程、摩爾定律推進趨緩,然而先進封裝技術已成為提升整體算力的關鍵戰場。
近期,市場流傳一份NVIDIA與供應鏈研發導入「CoWoP」的技術藍圖,這當中有什么值得觀察之處? 以下為進一步的分析解讀。
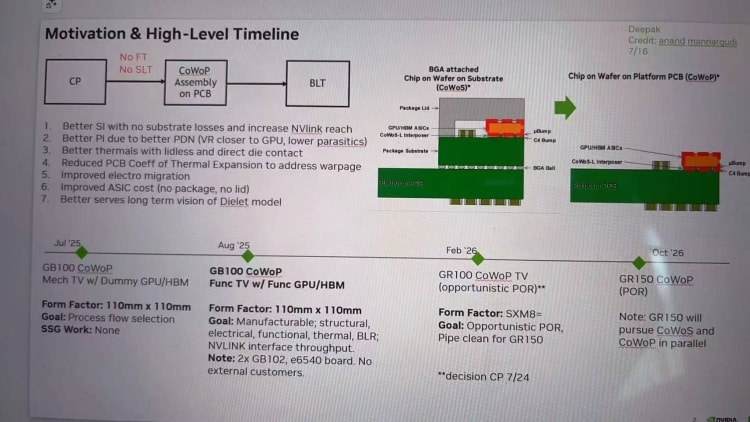
從CoWoS到CoWoP 減去封裝基板受矚
近期業界流傳一份名為「CoWoP」的全新封裝架構,亦即「Chip-on-Wafer-on-Platform PCB」的技術藍圖,據悉,為現有CoWoS的技術演進。
供應鏈業者透露,「CoWoP=CoWoS-基板」,據該資料顯示,CoWoP預計2026年10月在NVIDIA的GR150(Rubin)平臺上實現,將是CoWoS與CoWoP「并行」的先進封裝策略。
臺積電、NVIDIA將與日月光集團旗下的矽品、PCB、設備等供應鏈,預計2025年9月后,再研議討論450mmx450mm的可行性設計。
供應鏈業者表示,目前臺積電CoWoS(Chip-on-Wafer-on-Substrate),已成為特用芯片(ASIC)、NVIDIA H100、H200等更先進AI GPU的標配,其結構涵蓋芯片(GPU + HBM)、硅中間層(interposer)、封裝基板(Package Substrate),最終再以BGA方式焊接到服務器主板。
而據悉,CoWoP技術,簡單來說,就是「CoWoS減去封裝基板」。 也就是將芯片與中間層組合后,直接安裝在強化設計的主板(Platform PCB)上,跳過傳統的封裝基板與BGA步驟,主板需直接承擔高精度訊號與電源布線的功能。
這項刪減封裝基板一事看似容易,但在技術層面上則難度相當高。
NVIDIA企圖再建構護城河 CoWoP帶來七大改變
供應鏈業者表示,NVIDIA正計劃透過CoWoP,將原本集中于芯片制程的性能瓶頸,轉移至封裝與系統級互連,以此建立新的技術護城河。
整體而言,目標就是透過高度系統整合與平臺定義權,主導未來AI芯片的標準。
據供應鏈流傳的技術藍圖分析,CoWoP未來可帶來「七大改變」,包括:
一、訊號完整性(SI)提升:省去一層封裝基板,訊號路徑更短、更直接,NVLink和HBM通訊損耗顯著降低,傳輸距離可延長。
二、電源完整性(PI)強化:電壓調節器可更靠近GPU,減少寄生參數。
三、散熱效能提升:取消芯片上蓋(lid),芯片直接接觸,帶來更佳散熱效果。
四、降低PCB熱膨脹系數,解決翹曲問題。
五、改善電遷移(Electromigration)。
六、降低ASIC成本(無封裝、無蓋子)。
七、支持更彈性的芯片模塊整合方式,邁向無封裝架構長期愿景。
CoWoP有四大挑戰 載板技術成熟度高
不過,業界人士指出,CoWoP面對的挑戰仍不少,包括:
其一,主板技術門檻大幅提高,Platform PCB必須具備封裝等級的布線密度、平整度與材料控制。
其二,返修與良率壓力劇增,GPU裸晶直接焊接主板,失敗即報廢,制程容錯空間低。
其三,系統協同設計更復雜,增加開發成本。
其四,技術轉移成本高。
供應鏈認為,這一技術若順利推進,主板轉變為芯片的「最后一層封裝」,不僅能降低整體成本,更將主導AI硬件平臺的定義權。
不過也仍有PCB業者認為,目前載板技術相對成熟,價格合理,CoWoP欲取代傳統封裝,仍需時間。
盡管如此,目前市場盛傳的技術藍圖資料仍顯示,CoWoP已在2025年7月,被列入稱為GB100的內部測試平臺中,預計2026年10月在GR150平臺上,實現CoWoS與CoWoP并行封裝策略。
業界推估,臺積電、NVIDIA將與封測端的矽品、PCB、設備等供應鏈,在2025年9月供應鏈論壇后,可望再研議討論450mmx450mm尺寸可行性設計。
而據DIGITIMES Research初步分析,GB100、GR150等,推估是NVIDIA內部工程測試品,例如用上一世代的Grace CPU,搭配這一代的Rubin GPU平臺,或是Blackwell GPU平臺,進行先進封裝技術的各種研發討論,并不一定會商品化對外銷售,但在Vera CPU新平臺整裝上陣前,持續進行技術開發。
盡管如此,NVIDIA攜手臺積電等供應鏈,多方大膽嘗試先進封裝的進化可能性,確實是現在進行式。 預計2026年的半導體先進封裝技術發展,更為精彩。




評論