先進封裝技術及其對電子產品革新的影響
芯片封裝早已不再僅限于傳統意義上為獨立芯片提供保護和I/O擴展接口,如今有越來越多的封裝技術能夠實現多種不同芯片之間的互聯。先進封裝工藝能提高器件密度并由此減小空間占用,這一點對于手機和自動駕駛汽車等電子設備的功能疊加來說至關重要。芯片封裝行業的發展使國際電氣電子工程師協會電子元件封裝和生產技術學會(IEEE-CPMT)意識到必須要拓展自身的技術范疇,并于2017年正式更名為國際電氣電子工程師協會電子封裝學會(IEEE- EPS)。
本文引用地址:http://www.czjhyjcfj.com/article/202010/419639.htm有一種先進封裝技術被稱為“晶圓級封裝”(WLP),即直接在晶圓上完成集成電路的封裝程序。通過該工藝進行封裝,可以制成與原裸片大小近乎相同的晶圓。早在2000年代末,英飛凌開發的嵌入式晶圓級球柵陣列(eWLB)就是一種晶圓級封裝技術。目前有許多封測代工廠(OSAT)都在使用eWLB的變種工藝。具體來說,eWLB封裝是指將檢驗合格的晶片正面朝下,放置在載體晶圓上并將兩者作為整體嵌入環氧樹脂模具。在模鑄重構晶片結構之后進行“扇出型”封裝,在暴露的晶圓表面進行重布線層工藝(RDLs)并植球,之后再將其切割成小塊即可獲得可供使用的芯片(圖1)。
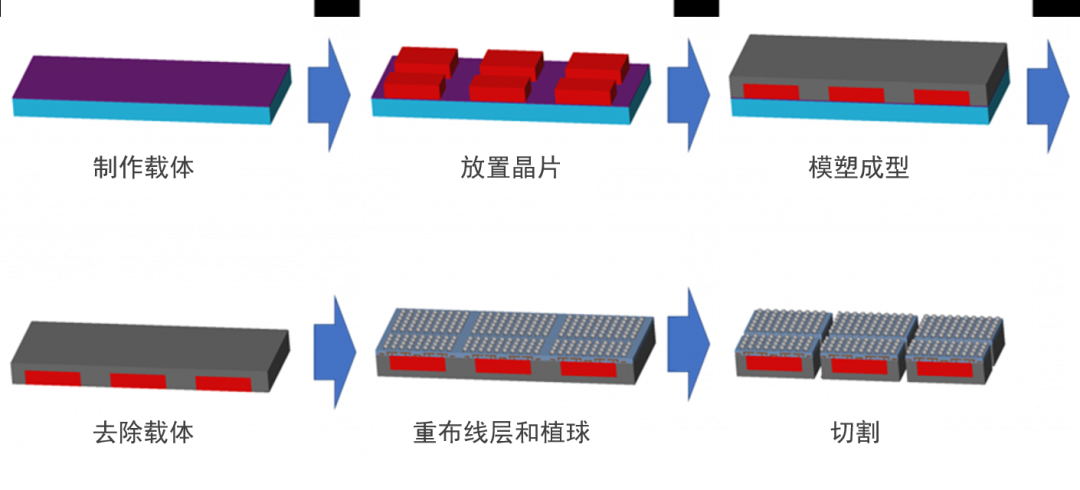
圖1 eWLB封裝流程
圖2展示的是其他結合晶圓級封裝的綜合性先進封裝技術。
硅通孔技術(TSV)是指完全穿透硅基底的垂直互連。圖2展示的是基于硅中介層的硅通孔技術,即通過硅中介層實現高密度晶片與封裝層之間的電氣連接。該技術起初作為打線接合的替代方法而備受推廣,能夠在減小互聯長度來優化電阻的同時,通過多個晶片堆疊實現3D集成。

圖2 器件封裝示意圖
作為導電互聯技術的應用,重布線層的作用是重新分布連接至晶片焊盤I/O點位的電子線路,并且可以放置在單個晶片的一側或兩側。隨著對帶寬和I/O點位需求的提升,重布線層的線寬和間距也需要不斷縮小。為了滿足這些要求,目前工藝上已采用類似后段制程的銅鑲嵌技術來減小線寬,并通過銅柱代替傳統焊接凸點的方法來減小晶片間連接的間距。
先進封裝技術還在持續發展,以滿足不斷提升的器件密度和I/O連接性能要求。近幾年出現的銅混合鍵合技術就是很好的例子,它的作用是直接將一個表面的銅凸點和電介質連接至另一個主動表面的相應區域,由此規避對凸點間距的限制。我們非常期待這些封裝技術上的創新能夠引領新一代電子產品的穩步發展。




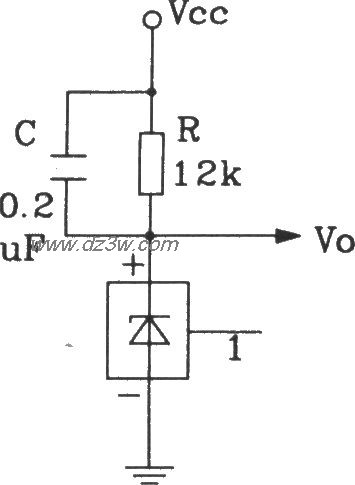

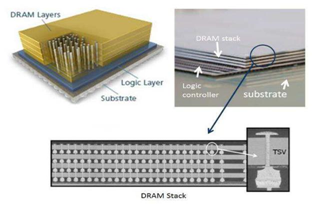


評論