LG Innotek 推出銅柱基板技術(shù),助力智能手機更輕薄
LG Innotek 宣布成功研發(fā)全球首款銅柱(Cu-Post)技術(shù),并將其應(yīng)用于移動半導(dǎo)體基板的量產(chǎn),據(jù)其 新聞稿 。正如 TechNews 引用 Tom’s Hardware 所述,LG Innotek 的 Cu-Post 技術(shù)取代了傳統(tǒng)的焊球連接芯片基板和主板的方式,使智能手機變得更輕薄且性能更高。

該報告指出,這項技術(shù)的核心在于首先在基板上放置銅柱,然后在銅柱上放置焊球。與直接將焊球附著在基板上的傳統(tǒng)方法相比,這種方法將焊球之間的間距減少了約20%,從而提高了封裝密度。
此外,該報告強調(diào),銅的熔點遠(yuǎn)高于焊料,使其在高溫工藝中能夠保持結(jié)構(gòu)穩(wěn)定性,并在焊接過程中防止焊球變形或位移。此外,銅的熱導(dǎo)率約為傳統(tǒng)焊料的七倍,能夠?qū)崿F(xiàn)更快的散熱。
根據(jù)其新聞稿,LG Innotek 已獲得約 40 項與其 Cu-Post 技術(shù)相關(guān)的專利,并計劃將其應(yīng)用于 RF-SiP 和 FC-CSP(翻轉(zhuǎn)芯片-芯片級封裝)基板。
該公司還旨在通過專注于高附加值產(chǎn)品,如 FC-BGA 和 RF-SiP 基板以及車載 AP 模塊,來擴大其半導(dǎo)體組件業(yè)務(wù),目標(biāo)是到 2030 年實現(xiàn)超過 22 億美元的年收入,根據(jù)新聞稿。
然而,正如 TechNews 所指出的那樣,雖然 LG Innotek 的銅柱封裝解決方案有可能重塑半導(dǎo)體封裝的格局,但該過程存在重大挑戰(zhàn)。TechNews 指出,微結(jié)構(gòu)制造需要極高的精度,使得芯片集成和生產(chǎn)良率難以管理。此外,銅的成本高于焊料,使得投資回報成為行業(yè)必須仔細(xì)評估的關(guān)鍵問題。




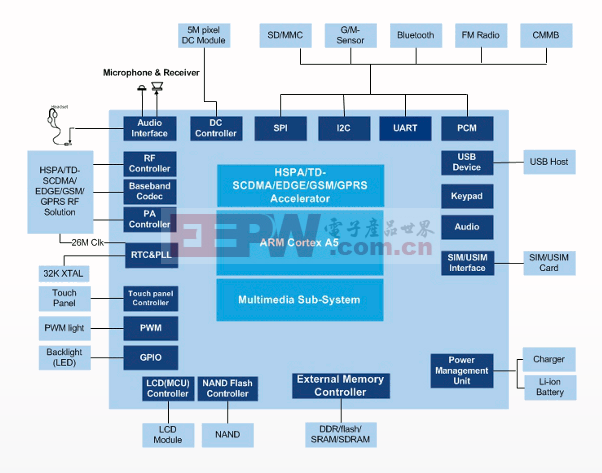
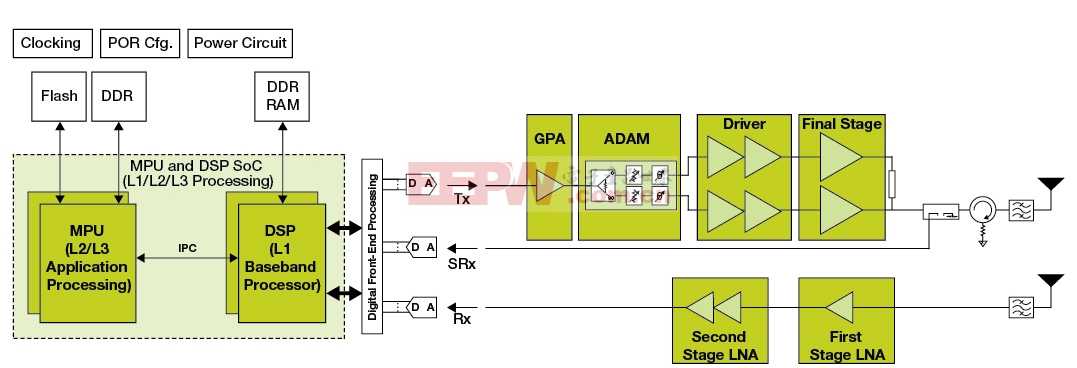








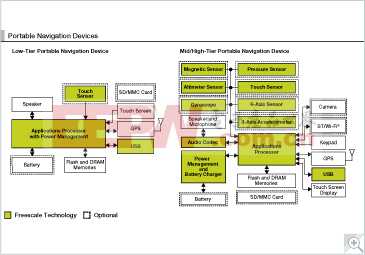
評論