3D封裝材料技術(shù)及其優(yōu)點
隨著移動電話等電子器件的不斷飛速增長,這些器件中安裝在有限襯底面積上的半導(dǎo)體封裝也逐漸變小變薄。3D封裝對減少裝配面積非常有效。此外,系統(tǒng)級封裝(SiP)技術(shù)(將二個或多個芯片安裝在一個封裝件中)對于提高處理速度和改善功耗的作用顯著(圖1)。為滿足這一要求,不僅是每一種封裝材料的特性非常重要,而且這些材料的組合也變得很重要。
本文引用地址:http://www.czjhyjcfj.com/article/194540.htm
本文重點介紹了材料、材料設(shè)計技術(shù)以及二者的結(jié)合,例如多芯片疊層封裝、用于堆疊封裝的環(huán)氧模塑料和襯底以及用于先進倒裝芯片封裝的底充膠材料。
3D封裝用的先進材料技術(shù)
先進封裝(包括3D封裝)將用到各種不同的材料。例如前道材料中的低K材料、緩沖涂層和CMP研磨料,后道材料中的芯片鍵合膜、漿料、環(huán)氧模塑料、液態(tài)模封材料、襯底、阻焊劑等等。采用這些材料可以制作各種各樣的先進封裝。
用于多芯片疊層封裝的芯片鍵合膜
存儲器件廣泛關(guān)注多芯片疊層封裝能否實現(xiàn)性能更高、體積更小且更薄。圖2(上)示出了多芯片疊層封裝的典型結(jié)構(gòu)和發(fā)展趨勢。此時,芯片鍵合膜(DAF)的性質(zhì)對提高封裝性能極為重要。晶圓厚度與日俱減,堆疊芯片的數(shù)目則不斷增加。由此產(chǎn)生了下列問題(圖2下):DAF層壓DAF后薄晶圓的翹曲;將芯片粘到襯底后封裝的翹曲;熱循環(huán)測試過程中的分層和芯片破裂。
為了解決這些問題,研發(fā)了用于DAF的新穎聚合物合金系統(tǒng)。這一材料的彈性模量低,抗熱性能好,能有效地減少疊層CSP的翹曲和熱應(yīng)力。
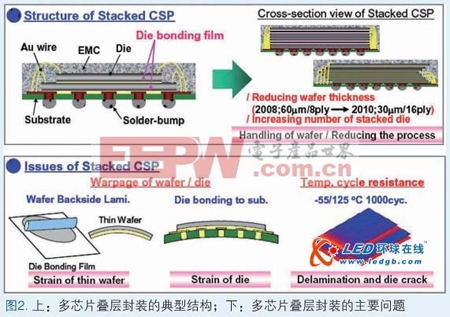
堆疊封裝(PoP)用的環(huán)氧模塑料和襯底
PoP是堆積一個或多個芯片封裝的安裝形式。一般說來,PoP是將存儲器封裝堆疊在邏輯封裝之上,以節(jié)省PCB空間。由于在PoP中的總封裝高度增加了,必須盡可能減薄襯底和模塑材料的厚度(圖3)。較薄封裝的麻煩之處是PoP的連接問題,這一點在頂層封裝和底層封裝的翹曲程度不一樣時尤為嚴(yán)重。所以,控制或減少每一封裝的翹曲很重要。由于襯底、環(huán)氧模塑料(EMC)和底充膠材料(UF)的熱膨脹性質(zhì)直接影響封裝的翹曲,因此,調(diào)整這些材料的性質(zhì)比過去更為重要。
襯底和EMC的熱膨脹系數(shù)(CTE)對封裝的翹曲有直接影響。用新樹脂系材料可以開發(fā)出適合于薄封裝的低熱膨脹系數(shù)襯底和高熱膨脹系數(shù)EMC.
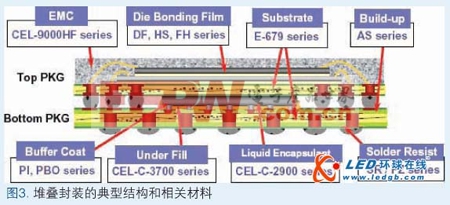
先進倒裝芯片封裝用的底充膠材料
如表1所示,倒裝芯片封裝的發(fā)展趨勢是密度更高、芯片與襯底間間隙更窄、芯片尺寸更大、速度更快(更低k值)。低應(yīng)力和窄間隙填充將來對底充膠材料越來越重要。另外,對超窄間隙封裝和硅通孔(TSV)封裝來說,迫切需要像不流動的底充膠材料和底充膠膜等預(yù)涂材料。正在開發(fā)滿足這一需求的新穎高強度樹脂系材料,這些材料對減少低k大芯片的破裂很有用。最新開發(fā)的底充膠膜特別適用于減少一些綜合工藝步驟。
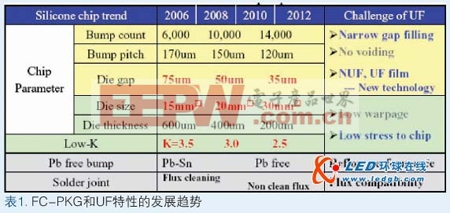



評論