GaN,迎來新突破!
來源:半導體行業觀察
如今,以碳化硅(SiC)、氮化鎵(GaN)等“WBG(Wide Band Gap,寬禁帶,以下簡稱為:WBG)”新型材料為基礎的功率半導體的研發技術頗受關注。基于日本環境省的“為進一步實現碳中和,加速推進應用和普及材料(氮化鎵)、CNF(碳納米纖維)”的方針,日本大阪大學森勇介教授一直致力于以高質量晶圓為基礎的半導體研發工作,此次,針對氮化鎵研發情況、研發成果對未來功率半導體應用場景的影響等,我們對森教授進行了采訪。
如今采用了寬禁帶材料的功率半導體已經開始實用化。據悉,美國特斯拉(Tesla)的電機(Motor)驅動逆變器(Inverter)采用了碳化硅半導體。此外,應該也有不少讀者在家電銷售中心等處見過一些采用了氮化鎵半導體的極小型交流轉換器(AC Converter)。在高電壓工作情況下,以寬禁帶材料制成的功率半導體的內部線路的電氣性能和有效性遠遠高于硅材質的傳統半導體。
對已經實現實用化的碳化硅半導體和氮化鎵半導體而言,應用終端對其耐電壓(Rated Voltage,比額定電壓高,是為維持信賴性的基本電壓)的要求不同,分別如下,碳化硅耐電壓1000V以上,氮化鎵耐電壓1000V以下。基于上述區分,功率半導體廠家和研發企業之間形成了“無言的默契”。
然而,上述情況很有可能發生變化。由于氮化鎵材料可大幅度降低晶圓的缺陷(錯位)密度,因此可以提高應用終端的性能、效率,且遠優于碳化硅材料,所以,氮化鎵有望實現大范圍量產。如今,研發人員正在努力積累相關數據,以證實上述結論。日本大阪大學的森勇介教授位于上述研發活動的最前沿。
氮化鎵功率半導體雖然適用性極高,但依然面臨三項社會問題
僅從物理特性來看,氮化鎵比碳化硅更適合做功率半導體的材料。
研發人員還比較了碳化硅和氮化鎵的“Baliga性能指數(半導體材料相對于硅的性能數值,即硅為1)”,4H-SiC為500,氮化鎵為900、效率極高。此外,碳化硅的絕緣破壞電場強度(表示材料的耐電壓特性)為2.8MV/cm,氮化鎵更高,為3.3MV/cm。一般情況下,低頻工作時的功耗損失是絕緣破壞電場的三次方,高頻工作時的功耗損失是絕緣破壞電場的2次方,成反比例關系,所以,氮化鎵的功率損耗更低(工作效率更高)。
那么,為什么在耐高電壓應用領域,碳化硅的實用化早于氮化鎵呢?理由如下,在制作MOS FET時,碳化硅更易于形成二氧化硅(SiO2)、“氮化鎵晶圓面臨三大問題點”(森教授)。(下圖1)

圖1:日本大阪大學森勇介列舉的氮化鎵晶圓面臨的問題點。(圖片出自:日本大阪大學)
第一個問題,由于 Bulk Wafer(氮化鎵體塊)的尺寸較小,因此之前僅能生產出低成本的晶圓產品,某些產品甚至無法滿足測試要求。一直以來,都僅能生產出2英寸晶圓,如今終于可以生產出4英寸晶圓。業界普遍認為只有6英寸以上的大尺寸晶圓才可以滿足功率半導體的批量生產需求,所以如今還沒有達到可以量產的要求。另外,上文中提到的小型交流轉換器(AC Converter)所采用的氮化鎵功率半導體采用的晶圓如下,在最大尺寸為6英寸的硅(Si)襯底上形成氮化鎵層。但是,由于硅和氮化鎵的結晶常數(Lattice Constant)不同,因此氮化鎵層的缺陷密度較高、無法形成可以滿足耐高電壓、大電流的縱型FET,也無法制作高性能的橫型HEMT。
第二個問題,作為結體塊式(Bulk)的氮化鎵晶圓本身質量不高。如今的結晶塊晶圓的最大錯位密度高達106/平方厘米,這種水平的密度水平是不適合功率半導體生產的。但是,2英寸晶圓的傾斜角(Off)的分布(是反映晶圓翹曲度的指標)為0.2度,很難實現大尺寸化和低成本化。但是,上述低質量的晶圓適合用于光學半導體的生產。不過,對于功率半導體而言,電流需要在晶圓的大部分區域流通,所以,錯位缺陷成為了耐高電壓、電流量、生產良率低的主要原因。要適用于功率半導體,需要滿足以下錯位密度要求:耐高電壓范圍需要為0.65~3.3kV,單個芯片(Chip)的電流量為100A以上,生產良率要達到90%(必須實現較低的錯位缺陷、較低的翹曲度)。
第三個問題,晶圓價格高昂。如今,2英寸晶圓的價格為10萬日元一一20萬日元(約人民幣5220元一一10440元)。之所以價格如此高昂,理由如下:還沒有確立一項技術,可以以較高的良率生產出大尺寸晶圓。尺寸為6英寸、價格在10萬日元(約人民幣5220元)以下的晶圓才適用于功率半導體的量產。
成功獲得適用于量產功率半導體的、高質量、大尺寸氮化鎵晶圓
氮化鎵晶圓之所以面臨上述問題的根本原因在于氮化鎵結晶的生長方法。如今量產的體塊式(Bulk)氮化鎵晶圓的制作方法如下,在藍寶石襯底(Sapphire)上用一種名為HEPV(Hydride Vapor Phase Epitaxial,氫化物氣相外延法,以下簡稱為:“HVPE”)的氣相外延法生成氮化鎵結晶。如果把藍寶石等用作結晶生長的基礎材料,由于氮藍寶石材料與氮化鎵的結晶常數(Lattice Constant)不同,因此會發生大批量的錯位缺陷。此外,利用“HVPE”,由于是在1000度的高溫下生成結晶的,所以在生長后常溫冷卻時,整個晶圓會出現翹曲,出現傾斜角(Off)。
此外,有一種名為“氨熱法(Ammono-thermal)”的結晶方法,該方法可生成高質量的結晶,不同于體塊式(Bulk)氮化鎵晶圓量產工藝中使用的“HVPE”法。“氨熱法”作為一種生成人工水晶結晶的方法,采用的是水熱合成法(已實現工業化應用)。提高壓力容器內氨的溫度和壓力,使其處于超臨界狀態,溶解氮化鎵多結晶,再在氮化鎵種晶(Seed Crystal)上沉淀出單晶。以氮化鎵晶種為基礎材料、并采用液相生長法,可制作出高質量的單結晶。“但是,利用氨熱法,在結晶生長過程中,一旦出現穩定的表面,就會停止生長。基于上述現象的存在,雖然可以制作4英寸晶圓,要想制作出更大尺寸的晶圓,還需要時間的積累。”(森教授)
然而,以往無法制作出高質量體塊式(Bulk)氮化鎵晶圓,近年來情況有了顯著改善。已經確立了可以制造出高質量、低成本體塊式(Bulk)氮化鎵晶圓的技術。日本大阪大學、豐田合成株式會社合作研發了一項可解決上述課題的新技術(下圖2),該技術融合了“Na Flux法(鈉助溶劑法,利用該方法生長氮化鎵結晶)”和“Point Seed 法(點籽晶法,利用該方法實現大尺寸晶圓)”。
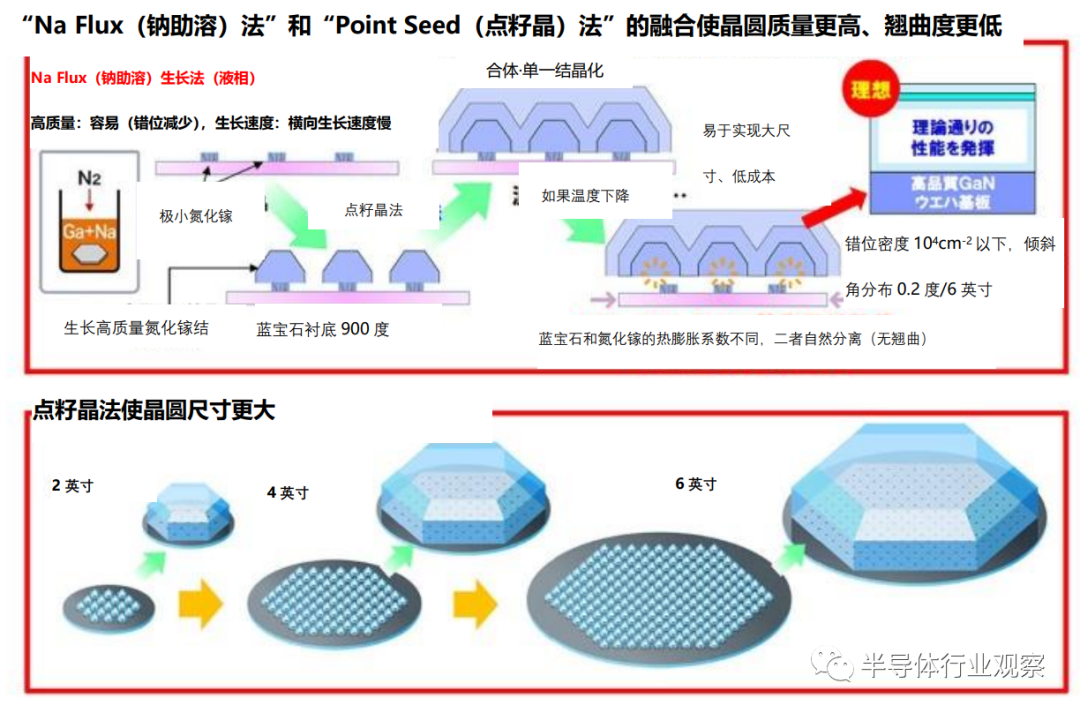
圖2:融合“Na Flux(鈉助溶)法”和“Point Seed(點籽晶)法”,使大尺寸體塊式(Bulk)氮化鎵晶圓的制作成為可能。(圖片出自:日本大阪大學)
“Na Flux(鈉助溶)法”指的是將鈉/鎵溶液暴露于氣壓為30一一40的氮氣中,將氮溶解于溶液,并使其成為飽和狀態,從而使氮化鎵結晶析出。這是日本東北大學山根久典教授于1996年研發出的技術。“Na Flux(鈉助溶)法”的特點是,即使晶種質量較低,也可以在其表面形成高質量的結晶。但是,僅靠該方法,雖然可以依靠一個小點形成完美的結晶,卻無法形成大尺寸結晶。于是,利用“Point Seed(點籽晶)法”,形成大尺寸的晶圓。即在大塊基材上大面積分布晶種,在結晶生長過程中,分別合體,形成單結晶。
據森教授表示,利用上述方法,可以獲得適用于功率半導體量產的理想結晶,其錯位密度為104/cm2以下,6英寸晶圓傾斜角分布為0.2度。此外,也已經成功制成了6英寸體塊式(Bulk)氮化鎵襯底(該尺寸為全球最大)。而且,如果使用尺寸更大的基材、更多的晶種的話,還可以制作出10英寸晶圓,且生產量不會降低。
此外,還有另一種方法,即以體塊式(Bulk)氮化鎵襯底為晶種,使用“氨熱法”,可制作出高質量、大尺寸的體塊式(Bulk)襯底(如下圖3)。針對上述方法,森教授指出:“成本堪比現有的碳化硅襯底,且可以實現較大尺寸。”日本大阪大學和豐田合成株式會社等企業已經參加日本環境省提出的“令和四年度 為進一步實現碳中和,加速推進應用和普及零部件和材料”項目,近期,三菱化學株式會社(擁有“氨熱法”技術)也加入了該項目,諸多企業的加入將更有助于項目的實施和驗證。
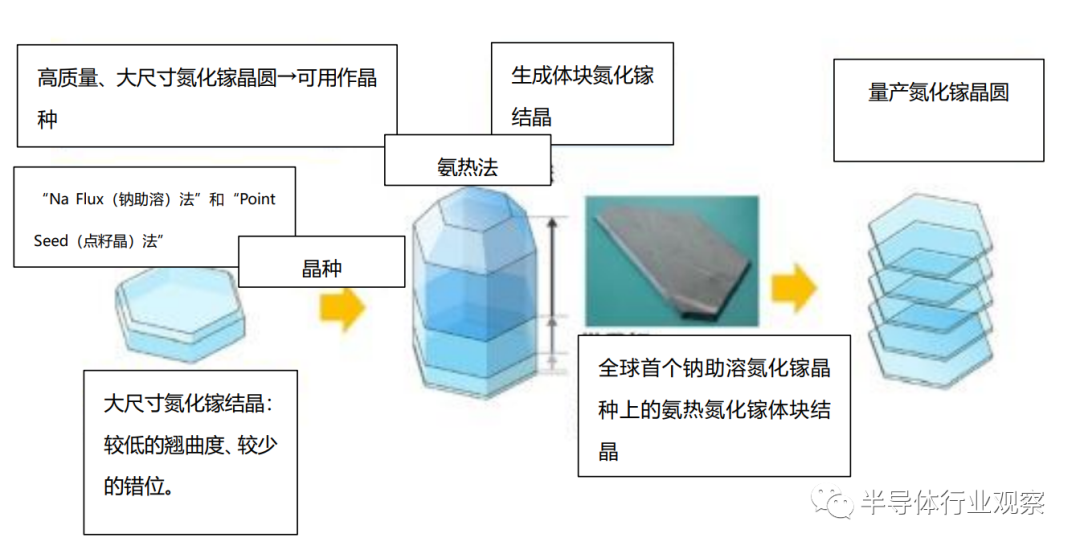
圖3:融合“Na Flux(鈉助溶)法”和“氨熱法”。“Na Flux(鈉助溶)法”的優勢是可使晶圓實現較大的尺寸、較高的質量;“氨熱法”的優勢是可提高晶圓質量。二者融合后,可以獲得比碳化硅成本更低的的氮化鎵晶圓。(圖片出自:日本大阪大學)
可成功提高元件的性能、良率
據森教授表示,使用由“Na Flux(鈉助溶)法”和“Point Seed(點籽晶)法”制成的氮化鎵襯底后發現,氮化鎵元件的性能、良率普遍得到提高。
日本大阪大學和松下集團合作,利用Na Flux(鈉助溶)法,以體塊(Bulk)襯底為基礎制作了縱型氮化鎵FET,并從芯片OFF性能的角度考察了成品率(下圖4)。以市場上銷售的氮化鎵襯底制成芯片的成品率僅為33%,而利用上述方法,則可使成品率大幅度提升至72%。此外,上述成果是基于實驗室基礎獲得的,未來還有很大提升余地。
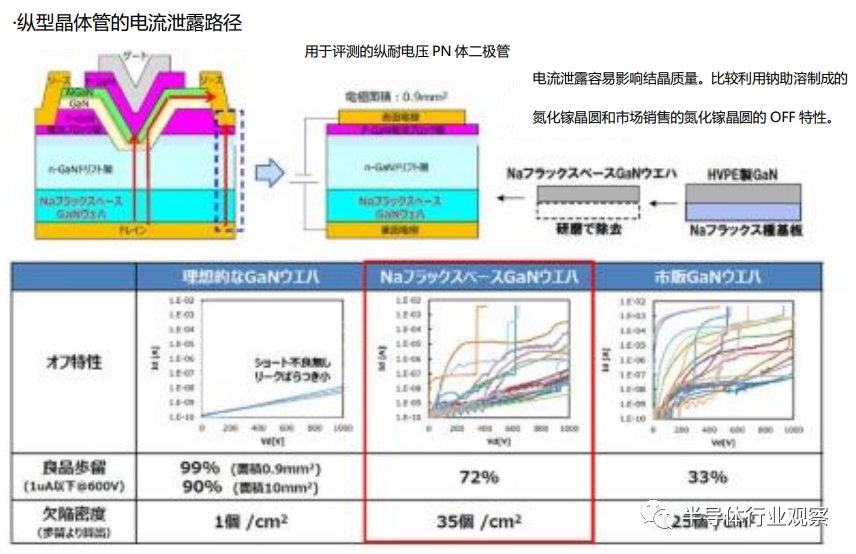
圖4:利用“Na Flux(鈉助溶)法”和“Point Seed(點籽晶)法”可制作出高質量、大尺寸的氮化硅襯底。(圖片出自:日本大阪大學)
此外,研究人員已經開始利用“OVPE法(Oxide Vapor Phase Epitaxy,氧化物氣相外延法,簡稱為:OVPE,可用于制作超低電阻的晶圓,由日本大阪大學研發、松下集團推進其實用化)”,在由“Na Flux(鈉助溶)法”和“Point Seed(點籽晶)法”制成的晶種上生長氮化鎵結晶,以研發更高性能的縱型氮化鎵FET。制成的晶圓的電阻約為10-4Ωcm2,遠低于碳化硅晶圓(10-3Ωcm2左右)、錯位密度為104/cm2、氮化鎵膜厚超過1毫米。研究人員獲得了一塊晶圓,該晶圓有望實現縱型FET。與碳化硅基的縱型MOS FET相比,在性能方面,縱型FET具有更高的潛力(下圖5)。與利用傳統的體塊式氮化鎵晶圓制成的芯片相比,實驗制作的二極管的ON電阻值降低了50%,縱型FET的OFF電阻值降低了15%(甚至更高)。

圖5:功率半導體的性能和晶圓特性的關系。利用“OVPE法”,可降低晶圓的電阻。(圖片出自:日本大阪大學)
在日本環境省的項目中,為實現在電動汽車驅動逆變器中的應用,日本大阪大學著力研發具有超低電阻、高質量、大尺寸的體塊氮化鎵襯底以及相關其他產品、模組。(下圖6)
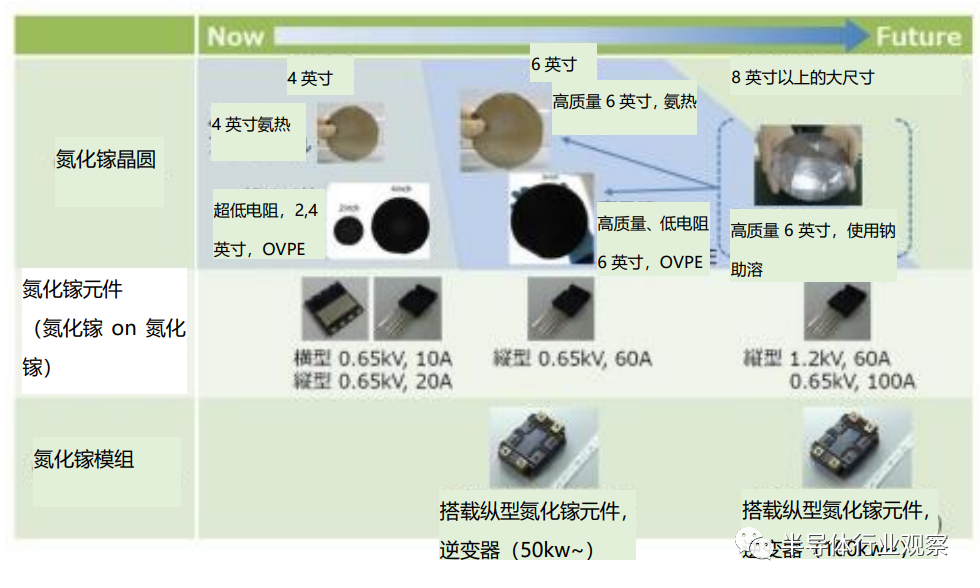
圖6:超低電阻、高質量、大尺寸的體塊氮化鎵晶圓、以及相關應用、模組的開發計劃。(圖片出自:日本大阪大學)
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。