高密度先進封裝(HDAP)急需從設計到封裝的一體化利器
作者 王瑩
本文引用地址:http://www.czjhyjcfj.com/article/201707/362285.htmHDAP的挑戰
有人認為摩爾定律在IC制程上已接近極限,但如果在封裝上繼續創新,例如利用疊層芯片封裝,摩爾定律還可以繼續走下去。因此,擴張式的摩爾定律會在封裝上實現,包括手機、通信、智能設備(諸如無人機等)、自動駕駛汽車、安全(security)、網絡、硬盤存儲器、服務器等,都將受益于HDAP(高密度先進封裝)的創新。
傳統封裝在基板上有引腳,現在基板上的引腳數量越來越多,誕生了各種新型封裝,諸如TSMC的扇出晶圓級封裝(FOWLP),interposer-based(基于中間層的) 封裝(也稱2.5D封裝),chip-on-wafer-on-substrate(CoWoS),高引腳數的倒裝,SiP(系統封裝,也稱3D封裝)。這些新型封裝技術把過去單一的die(裸片)進行連接,采用多die或多球方式,同時放進一個封裝中。例如可把海力士的4個存儲器和高通的邏輯芯片堆疊在一起。
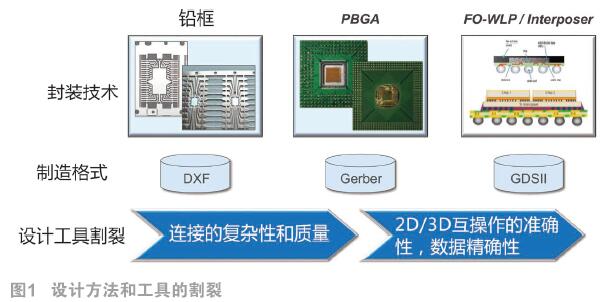
這種封裝的創新也帶來了技術上的巨大挑戰。例如使傳統的格點式的PBDA發生變化,諸如有些處理器公司在做不對稱的點。另外也需要知道引腳在有限面積是否放得下。另外,Bumping(凸塊)、 micro bumping(微凸塊)的間距越來越近,例如bumping的最細間距已到2微米X2微米數量級,如何把如此多的凸塊放在如此高的密度上,并通過驗證,是一大挑戰。再有,如果采用橫向接interposer,細通孔如何對齊?再例如,通常最簡單的是lead frame(鉛框)方式,可直接接出去,通過2D軟件(例如AutoCAD DXF);到了PCB階段,排球用Gerber設計工具;到了wafer(晶圓片)級,使用GDSII(如圖1)。但是Gerber和GDSII有所區別,例如Gerber只有繞線信息,GDSII有很多管理信息;Gerber有曲線、45°交互線,而GDSII只有0°和90°正交線等,因此為了流程進到生產環節,需要驗證工具,以檢查是否有bug(錯誤)。最后,設計的重要性也大為提高,過去設計失敗是一個die的失敗,現在由于是疊層,將是多個die同時失效。
美國市場分析公司Techsearch International的總裁Jan Vardaman預計 ,FOWLP在 2015 年至 2020 年內的增長率將達到驚人的 82%。但是FOWLP 會干擾傳統的設計和制造供應鏈。與其他高密度先進封裝技術一樣,它將推動對設備與封裝協同設計以及新流程的需求。
與此同時,IC 設計和封裝設計領域的融合也愈發明顯。例如目前從事HDAP的企業主要有兩大陣營:1.從晶圓廠切入,例如TSMC(臺積電);2.封測廠。以上這些就為現有的傳統設計方法帶來了挑戰,迫切需要更為高效的全新流程、方法和設計工具。
為此,Siemens 業務部門Mentor不久前推出了一款適用于HDAP的獨特端到端解決方案,滿足FOWLP等高密度先進封裝技術。
Mentor用Xpedition工具與OSAT聯盟迎戰HDAP時代
Mentor Xpedition的HDAP 流程是業內率先針對當今先進的 IC 封裝設計和驗證的綜合解決方案。獨特的Xpedition Substrate Integrator(xSI)工具可快速實現異構基底封裝組件的樣機制作。針對物理封裝實施的新型 Xpedition Package Design(xPD)技術可確保設計 Signoff 與驗證的數據同步。Integrated Mentor HyperLynx技術提供了 2.5D/3D 仿真模型和設計規則檢查 (DRC),可在流片之前精確地識別和解決設計錯誤。Calibre 3DSTACK 技術可針對各種 2.5D 和 3D 疊層芯片組件進行完整的 Signoff 驗證。
另外,為了簡化HDAP設計和制造,Mentor還宣布推出 Mentor OSAT(外包裝配和測試)聯盟計劃,幫助推動生態系統功能,以支持新型HDAP技術,如針對客戶集成電路 (IC) 設計的 2.5D IC、3D IC 和FOWLP。由于這些技術要求芯片與封裝具有更緊密的協同設計,推出此項計劃后,Mentor 將與 OSAT 合作為無晶圓廠(fabless)公司提供設計套件、認證工具和最佳實踐方案,幫助新型封裝解決方案更順利的應用于實際芯片。封測公司Amkor已成為首個 OSAT 聯盟成員。
據悉,Mentor在HDAP方面已深耕多年。據Mentor亞太區PCB資深業務發展總監孫自君先生介紹,過去Mentor已有Xpedition和改進版的Xpedition Package Integrator(XPI),設計和驗證的集成度很高。但實際上,即使在同一家公司,也需要在不同職務間交互,而并非一人就能全部完成。因此此次Mentor把XPI分拆成兩個工具—xSI(Xpedition Substrate Integrator)和 xPD(Xpedition Package Designer),前者偏前端設計,后者偏后端驗證。
本文來源于《電子產品世界》2017年第8期第81頁,歡迎您寫論文時引用,并注明出處。









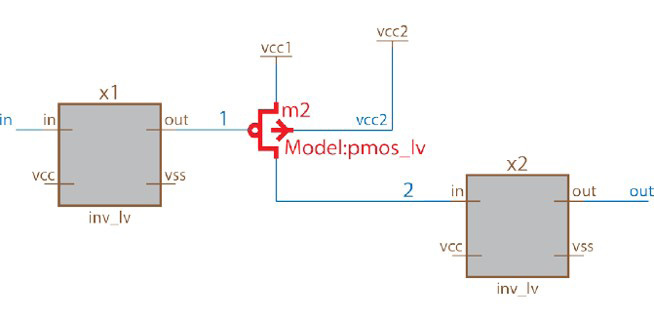
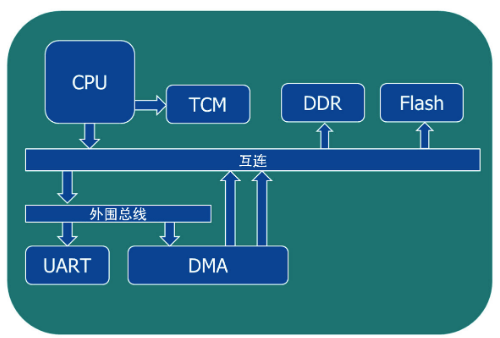

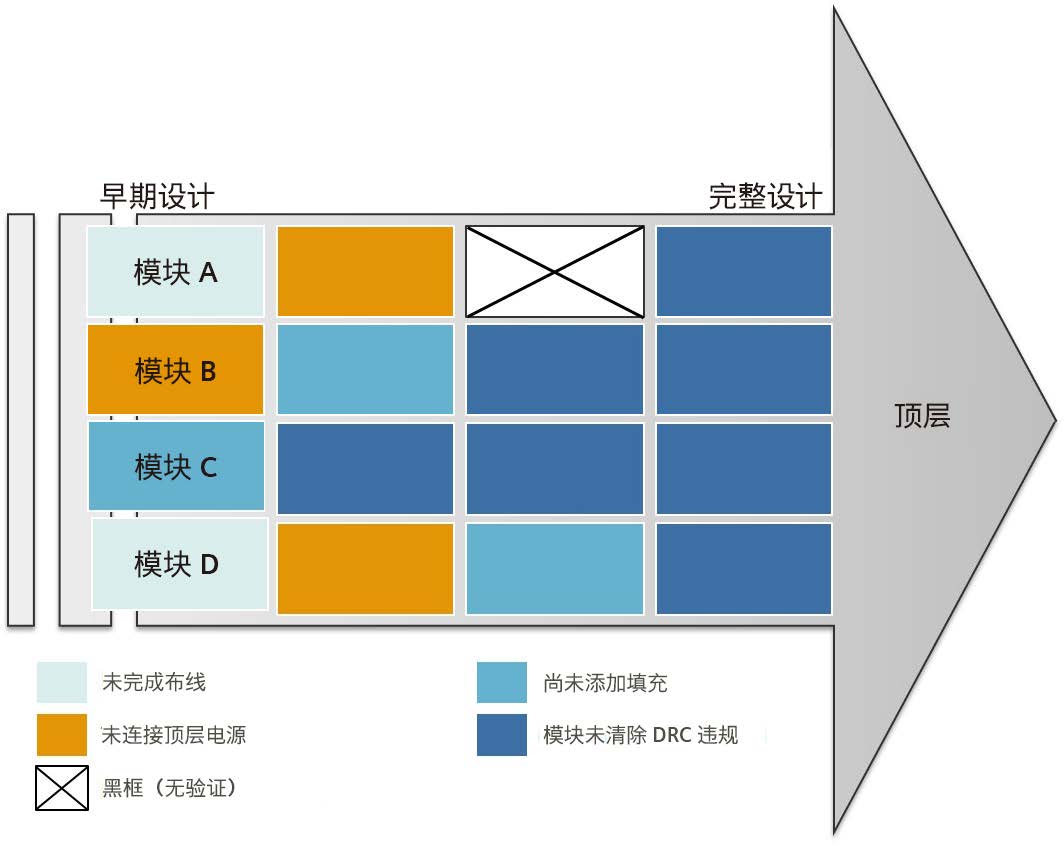



評論