普萊信智能發(fā)布新一代Fluxless TCB設(shè)備,引領(lǐng)CPO封裝設(shè)備發(fā)展
普萊信智能正式發(fā)布其新一代的Fluxless TCB 設(shè)備 Loong Advance, 該設(shè)備采用甲酸還原系統(tǒng),貼裝精度高達(dá)±0.5微米,該設(shè)備將廣泛應(yīng)用于未來(lái)的CPO,2.5D,3D等先進(jìn)封裝和Cu-Cu鍵合工藝。
CPO作為一種革命性的光電集成技術(shù),將傳統(tǒng)分離的光學(xué)組件包括電子集成電路(EIC) 、光子集成電路(PIC)集成在同一封裝基板或中介層(Interposer)上,便構(gòu)成了光引擎(OE),它被安裝在基板上的 ASIC 芯片周圍。相較于傳統(tǒng)可插拔光模塊,CPO將能耗降低50%、延遲壓至1納秒內(nèi)、信號(hào)完整性優(yōu)化了18dB(63倍)、支持1.6T以上超高帶寬、更高集成度等優(yōu)勢(shì),正在高速數(shù)據(jù)中心、人工智能計(jì)算集群和通信網(wǎng)絡(luò)等領(lǐng)域掀起變革浪潮。

據(jù)權(quán)威機(jī)構(gòu)預(yù)測(cè),全球CPO市場(chǎng)規(guī)模從2024年4600萬(wàn)美元增至2030年81億美元(年復(fù)合增長(zhǎng)率137%)。
在當(dāng)前的早期發(fā)展階段,CPO面臨熱管理(3D堆疊溫度>85℃)、封裝良率(<85%)、成本高等瓶頸。CPO模塊成本數(shù)千美元,封裝制造占總成本的30%-50%+,需規(guī)模化降本,隨著技術(shù)成熟和量產(chǎn),這個(gè)比例有望大幅下降。

在CPO封裝制造中,EIC和PIC的集成是最關(guān)鍵的步驟之一,英偉達(dá)的Spectrum-X Photonics CPO交換機(jī),采用臺(tái)積電的COUPE技術(shù)(基于混合鍵合的3D封裝技術(shù));英特爾的光學(xué)計(jì)算互聯(lián)(OCI)的CPO,采用硅中介層+TCB(熱壓鍵合)實(shí)現(xiàn)光電集成;博通BCM78909的CPO由臺(tái)積電代工制造,采用的也是TCB(基于硅中介層的 2.5D 封裝技術(shù))。
TCB是目前CPO封裝最成熟,成本最低的方案,F(xiàn)luxless的TCB,去除了傳統(tǒng)TCB使用Flux可能給光芯片帶來(lái)助焊劑污染的可能,是未來(lái)CPO量產(chǎn)的核心設(shè)備。
CPO量產(chǎn)的核心挑戰(zhàn)
盡管 CPO 在性能和成本方面優(yōu)勢(shì)顯著,但行業(yè)在量產(chǎn)過(guò)程中仍需解決諸多挑戰(zhàn):
1. 首先是封裝工藝復(fù)雜。CPO 系統(tǒng)需要高度復(fù)雜的先進(jìn)封裝技術(shù),如熱壓鍵合(TCB)或混合鍵合,還需實(shí)現(xiàn)光學(xué)耦合的精密集成、嚴(yán)格的測(cè)試流程和良率管理,以確保系統(tǒng)可靠性。
2. 其次是硅兼容性問(wèn)題。業(yè)界存在疑問(wèn):基于硅的光子集成電路(PIC),尤其是光電二極管(PD),能否在性能上實(shí)現(xiàn)足夠突破,與采用磷化銦(InP)光電二極管的傳統(tǒng)光模塊競(jìng)爭(zhēng)。
3. 再者是耐久性與熱管理。由于所有光學(xué)組件將緊密封裝在交換機(jī) ASIC/xPU 系統(tǒng)內(nèi)部,組件必須能承受高溫并保持穩(wěn)定性能,這對(duì)耐久性和熱管理提出了極高要求。
4. 最后是可靠性問(wèn)題。光引擎(OE)與 ASIC 緊密集成在同一 PCB / 基板上(未來(lái)甚至可能集成在中介層上),這意味著生產(chǎn)或運(yùn)行中只要單個(gè)光引擎失效,整個(gè)封裝(包括高成本的交換機(jī)或 xPU 芯片)就可能報(bào)廢。因此,封裝前對(duì)光引擎的測(cè)試至關(guān)重要,直接影響產(chǎn)品良率和可靠性。
TCB工藝為何成為首選?
TCB工藝以精準(zhǔn)控溫、亞微米精度、可控應(yīng)力三大優(yōu)勢(shì),成為EIC和PIC異構(gòu)集成的首選可行方案,完美應(yīng)對(duì)復(fù)雜封裝工藝的挑戰(zhàn):
1. 低溫鍵合(解決熱損傷):邦頭精準(zhǔn)溫度控制在150~200℃(遠(yuǎn)低于回流焊的250℃+),僅對(duì)凸點(diǎn)局部加熱,避免整體基板升溫,保護(hù)熱敏光學(xué)元件。
2. 亞微米級(jí)貼裝精度(光耦合關(guān)鍵):實(shí)時(shí)光學(xué)對(duì)準(zhǔn)+閉環(huán)控制,動(dòng)態(tài)調(diào)整貼裝頭位置,補(bǔ)償熱漂移,實(shí)現(xiàn)超高精度光學(xué)對(duì)準(zhǔn)(亞微米級(jí)),CPO實(shí)現(xiàn)高效光耦合的關(guān)鍵。
3. 無(wú)助焊劑工藝(避免光學(xué)污染):采用無(wú)助焊劑工藝,避免光學(xué)污染,光學(xué)界面保持極高的潔凈度。
4. 應(yīng)力管理(解決CTE失配):精準(zhǔn)力控,施加5~50N柔性壓力,避免脆性PIC破裂;凸點(diǎn)材料創(chuàng)新,采用低模量焊料(如In/Sn合金)或銅混合鍵合,吸收應(yīng)力。
5. 高密度互連:支持微凸塊間距低至10μm以下,實(shí)現(xiàn)電芯片與硅光芯片之間大量的電信號(hào)連接(I/O數(shù)量多)。
6. 良好的材料兼容性:CPO封裝涉及多種材料(硅、III-V族化合物半導(dǎo)體、玻璃、有機(jī)基板、金屬等),互連工藝需要與這些材料兼容。

普萊信智能——中國(guó)TCB設(shè)備的引領(lǐng)者
普萊信推出的Loong系列TCB熱壓鍵合機(jī)打破國(guó)際壟斷,最新推出的Fluxless TCB設(shè)備Loong Advance,適用于CPO、HBM、CoWoS、oDSP等TCB工藝,為客戶提供覆蓋研發(fā)、打樣至量產(chǎn)的全閉環(huán)支持,迄今為止,普萊信已經(jīng)為10余家客戶完成TCB的打樣,涉及到2.5D,3D,CPO等多個(gè)領(lǐng)域,是國(guó)產(chǎn)唯一一家能為客戶提供工藝開(kāi)發(fā),打樣和設(shè)備的國(guó)產(chǎn)廠家。普萊信的DA403COB/COC超高精度固晶機(jī),目前已大批量供貨全球最大的光模廠商,F(xiàn)luxless TCB設(shè)備Loong Advance將助力國(guó)產(chǎn)CPO廠商實(shí)現(xiàn)規(guī)模化量產(chǎn)和降本增效。隨著CPO向3.2T+時(shí)代邁進(jìn),TCB將進(jìn)一步融合激光加熱、銅直鍵合(Cu-Cu Direct Bonding)等技術(shù),作為下一代CPO的關(guān)鍵技術(shù),將支撐光電芯片的“摩爾定律”延續(xù)。







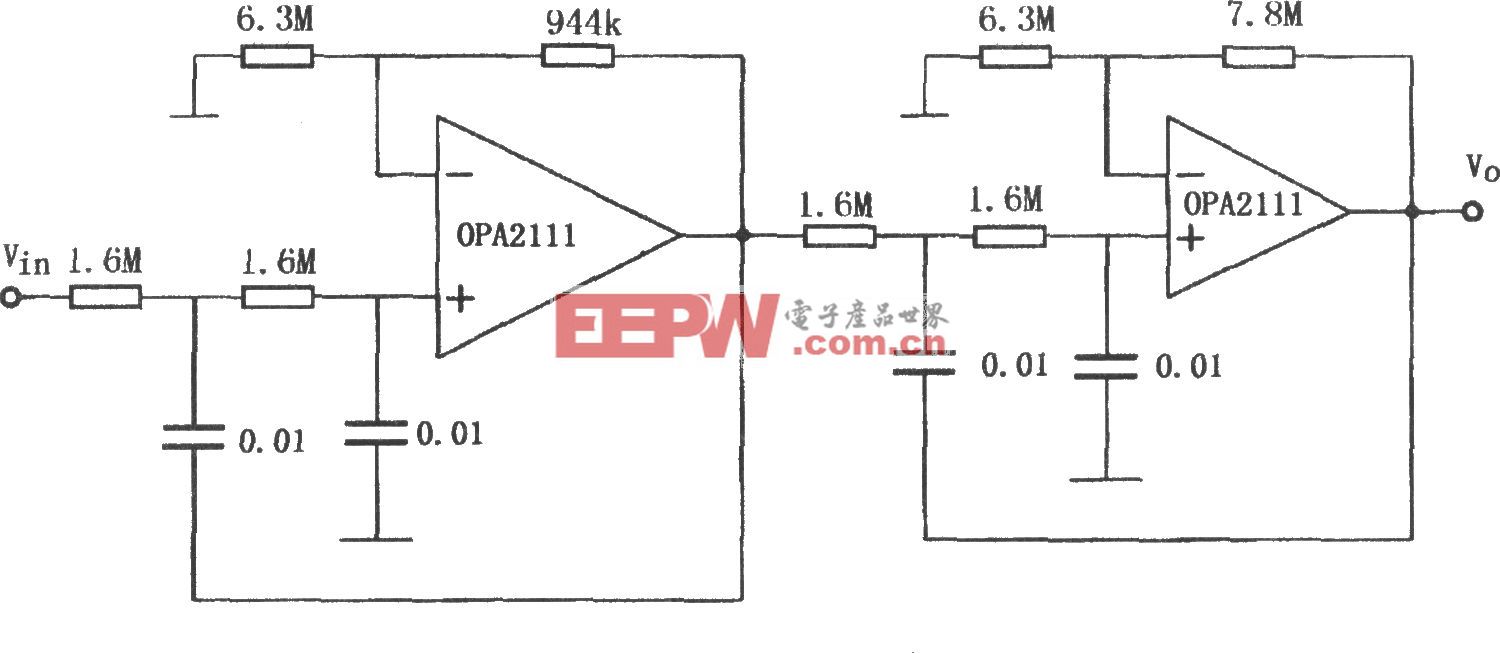






評(píng)論